全国服务热线:400-630-6556
- 中文版|
全国服务热线:400-630-6556
BGA 封装技术具有引脚数目多, I O/端子间距大 (如可达 1.00 mm , 1.27 mm , 1.50 mm)、引线间电感和电容小 、增强电性能与散热性能等一系列优点 , 因而发展速度很快, 并已在很多国际[敏感词]公司 (如IBM 、SUN 、NG体育通、松下、MO TO RO LA 等 )的产品中得到应用。
虽然 BGA 封装器件的性能较其它封装器件的性能有很大的改善, 但由于 BGA封装器件的焊点都隐藏在器件体下, 焊点缺陷的检测比较困难。一般情况下, 制造者都是采用目视观察的方法, 观察最外面一圈焊点的塌陷是否一致, 再将芯片对着光线观察, 如果每一排每一列都能透过光, 那么可以初步断定没有桥连, 有时尺寸大一点的焊锡球也能看见。但是用这种方法判断焊点是否有缺陷就难以令人满意, 因为不能或难以判断其里面的焊点是否存在其它缺陷或焊点里面是否有空洞 。要想不破坏BGA 封装器件本身的结构、性能等, 就可以看出BGA 封装器件内在的缺陷或者是更加准确地检测出焊点的质量, 就必须采用其它更为先进 、可靠的无损检测方法。对于表面组装焊点, 常用的无损检测方法是 X 射线检测, 使用 X 射线检测仪检查 BGA 封装器件的焊点, 可以快速、准确地检测出 BGA 封装器件中焊点的桥连、空洞、虚焊等缺陷, 在 BGA 封装器件焊点的质量检测方面得到广泛应用。
BGA 封装器件的缺陷的检测问题有两类:
1)BGA 封装器件本身的检测。在 BGA 封装器件的生产过程中, 可能会造成焊球丢失、焊球过小或过大、焊球桥连以及焊球缺损等 。对 BGA 封装器件进行检查, 主要是检查焊球是否丢失或变形。
(2) BGA 封装器件组装焊点的检查。主要检查焊点是否存在桥接、开路、钎料不足、缺球、气孔、移位等。
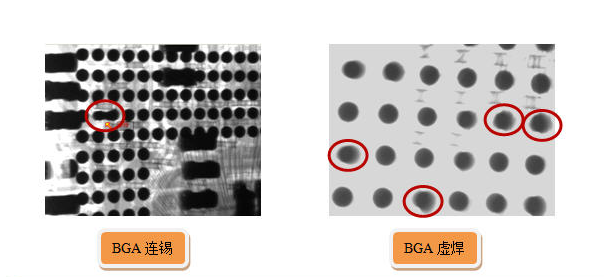

气泡 空洞
随着BGA封装器件的出现并大量进入市场,针对高封装密度,焊点不可见等特点,电子厂商为控制BGAS的焊接质量,需充分应用高科技工具,手段,努力掌握和大力提提高检测技术水平,使用新的工艺方法能有与之相适应,相匹配的检测手段。只有这样,生产过程中的质量问题才能得到有效控制。而且,把检测过程中反映生产更加顺畅,减少返修工作量。

全国服务热线
版权所:NG体育·(中国)股份有限公司
地址:深圳市宝安区松岗镇潭头社区广深路段2号厂房2栋三楼B区、3栋3楼
电话:0755-29411968 传真:0755-27330185 E-mail:elt@elt-usa.com
半导体检测设备生产厂家,品牌定制,批发价格,供应哪家好

微信公众号

手机网站